11.
Распределение примеси в результате ионной имплантации, сравнение избирательного
легирования термической диффузией и ионной имплантацией. Комбинированный и
ступенчатый процессы ионной имплантации. Рекомендации по их применению.
Йонные примеси можно ввести в пластину если сообщить
достаточную энергию и направить на пов-ть пластины. Йоны буду внедряться в
кристаллическую решетку, испытывать соударения, электровзаимодействие.
Соударение – изменение межузлового пространства. Электровзаимодействие –
торможение, занятие места в кристалле, но вероятность этого мала. Проекция на
направление внедрения – функциональная длина пробега. 3 направления –
(1,1,1);(1,1,0);(1,0,0);


Позволяет
получать пластины
с Q=10^15
и
глубиной лег. 0.5 мкм
Для создания
пластин с определенной глубиной легирования, применяют ступенчатое легирование.
+: высокая
точность, комнатная температура,отсутсвие боковой диффузии,очищение примеси до
изотопной чистоты,точное дозирование, размер области легирования соответсвует
размеру маски.
-: дороговизна,
необх. защита от радиации, малая толщина легирования, сложность установки.
 12. Сущность процесса ионной имплантации; схема рабочей камеры.
12. Сущность процесса ионной имплантации; схема рабочей камеры.
.
Йонные примеси можно ввести в пластину если сообщить
достаточную энергию и направить на пов-ть пластины. Йоны буду внедряться в
кристаллическую решетку, испытывать соударения, электровзаимодействие.
Соударение – изменение межузлового пространства. Электровзаимодействие –
торможение, занятие места в кристалле, но вероятность этого мала. Проекция на
направление внедрения – функциональная длина пробега. 3 направления – (1,1,1);(1,1,0);(1,0,0);
13. Классификация методов
литографии. Использование процессов литографии в производстве ИМС.
Литография
– процесс формирования отверстий в масках, создаваемых на поверхности пластины,
предназначенных для локального легирования, травления, окисления, напыления и
других операций.
Классификация:
1.
Фотолитография:
основывается на использовании светочувствительных полимерных материалов –
фоторезистов, которые могут быть негативными и позитивными. Позитивные
фоторезисты обеспечивают более резкие границы проявлённых участков (повышенная
разрешающая способность).
2.
Рентгеновская
литография: использует мягкое рентгеновское излучение с длиной волны около 1
нм. Метод является контактным (но оставляется зазор в 10 мкм.
3.
Электронно-лучевая
литография: использует облучение резиста (электронорезиста) потоком электронов.
Она может быть проекционной (Применяется маска) и сканирующей(Шаблон
отсутствует, а экспонирование осуществляется перемещением по поверхности
пластины остросфокусированного электронного луча. Управляется с помощью ЭВМ).
4.
Ионно-лучевая
литография: использует облучение резиста потоком ионов и может быть
проекционной и сканирующей. Чувствительность резистов к ионному излучению выше.
Большая разрешающая способность. С помощью сканирующего ионно-лучевой
литографии можно создавать маску в слое SiO2 или рисунок тонких металлических
слоёв не только без шаблона, но и без слоя резиста, используя ионное травление.
14. Технологические
операции процесса литографии. Схема процесса контактной литографии.
Основные
этапы процесса литографии на примере получения маски SiO2. На окисленною поверхность кремниевой
пластины наносят несколько капель раствора фоторезиста. С помощью центрифуги
его распределяют тонким слоем по поверфности пластины, а затем высушивают. На
пластину накладывается фотошаблон рисунком к фоторезисту и экспонируют. Затем
его снимают. После проявления негативный фоторезист удаляется с незасвеченных
участков, а позитивный – с засвеченных. Получается фоторезистивная маска, через
которую далее травят слой оксида. После чего фоторезист удаляется.
16. Операция
совмещения. Виды знаков совмещения, последовательность их формирования.
Фотошаблон
накладывается к поверхности фоторезиста картинкой и экспонируется, Под
совмещением понимается точная ориентация фотошаблонов относительно пластины Si, при котором элементы очередного
топологического слоя (на фотошаблоне) занимают положение относительно элементов
предыдущего слоя.(пластина). Процессы совмещения включают три этапа
1.Предварительное
ориентация по базовому срезу, обеспечивает на границах модулей групповой
пластины наивыгоднейщую кристаллографическую плотность с точки зрения
разделения пластины на отдельные кристаллы.
2.Предварительное
грубое совмещение по границе крайних модулей, имеющее целью исключить поворот
пластины и фотошаблона относительно вертикальной оси z.
3.Точное
совмещение, исключающее смещение рисунка фотошаблона и пластины относительно
осей х,у.
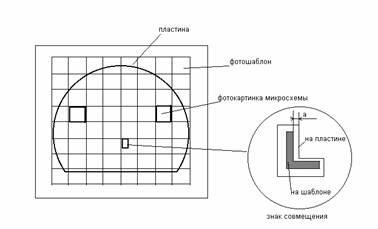
17. Особенности процесса проекционной
фотолитографии.
Особенности:
Операции
совмещения: изображения ФШ(фотошаблон) и пл. проектируются в одну плоскость,
следовательно повышается точность.
 Трудно создать оптическую систему
,которая может осуществить экспонирование сразу на все плоскость, поэтому
экспонирование осуществляется фотоповторителем.
Трудно создать оптическую систему
,которая может осуществить экспонирование сразу на все плоскость, поэтому
экспонирование осуществляется фотоповторителем.
Использование
фотоштампов.
Повышаются
требования к равномерности ФР(фоторезист) для того чтобы снизить погрешность.

18. Электронолитография.
Возможности процесса.
электронолитография-формиование
рисунка на плате или ФШ,покрытый слоем е-резистом с помощью эл.луча
е-резист
не чувствителен к свету,полимерным матерьялам.Пучок е приводит к появлению доп
связей или наоборот
Собственное
разрешение ~(вместо е резистора можно принять!так в лекциях я хз)
-Возможно
избирательно экспенировать без наличия ФШ
е литография
Проекционная Сканирующая(используется
спец вакумная камера)
---------------------------------------------------------------------------------------------------------------
Сканирующая
е литография
1
Вакум камера
2
е пушка
3устройство
прерывания луча
4устр
отклонения луча
5пластина
со слоем е резиста
6столик
который может перемещаться(с водкой)
Топология
заложена в прогу,в соот-ие с которой осущ-ся формирование тополог слоя,при
котором
формируется
раз-р эл-та при сканирование=>перемещения е пучка.ъ
Сканирование
растровая векторня
Достоинстава
е сканирования
-позволяет
исп-ть ФР малой величины <1мкм
-топология
слоя может сформирована по пл без ФШ
-установка
и литография позволяет осущ высокую автоматизацию
Т.к. е луч может осущ сканирование знака на
пластине,то может осущ совмещение
Недостатки
-низкая
ардитивность хз что такое)
-очень
малая производительность
е
луч может сфокусировать диаметром не больше 0.1мкм
Применение
-в
лаб иследовательных разработках
-других
производствах ФШ
-в
тех случаях,когда н.обеспечить формирование рисунка топологии непосредственно
на пл
20. Критерии качества при переносе рисунка
(Разрешение, смещение, селективность и контроль размеров элементов).
Критерии качества показывают точность и
технологичность изготовления МС. Перенос рисунка является основной операцией
формирования структуры будущей МС, поэтому погрешности и ошибки на этом этапе
влекут брак изделия. Разрешение показывает, каков минимальный размер элемента,
изготовляемого на кристалле по данной технологии имеет порядок нанометров в
настоящий момент. Смещение показывает, на сколько рисунок последующей операции
переноса (например фотолитографии) отличается от предыдущего(смещен
относительно предыдущего в отличие от того что было предписано топологией). Для
точного совмещения слоев используются знаки совмещения, расположенные по краям
поверхности МС. Селективность - возможность избирательного проведения процесса
переноса, по отношению к разным материалам. Качество проведения переноса
проверяется контролем размеров элементов. Каждый (или основные – в зависимости
от технологии) элемент под микроскопом (автоматически или оператором)
сравнивается с идеальным. Если размеры отличаются – то либо МС отправляется в
брак. Либо, если предусмотрено тех. процессом на подгонку – удалением лишних
слоев и уменьшением размера, с последующим восстановлением защитной пленки. В
настоящее время технология имеет тенденцию к миниатюризации и процессы переноса
и контроля усложняются, а ответственность на этих этапах повышается.